Occasion EATON NOVA / AXCELIS GSD 200E2 #9021872 à vendre en France
Il semble que cet article a déjà été vendu. Consultez les produits similaires ci-dessous ou contactez-nous et notre équipe expérimentée le trouvera pour vous.
Appuyez sur pour zoomer
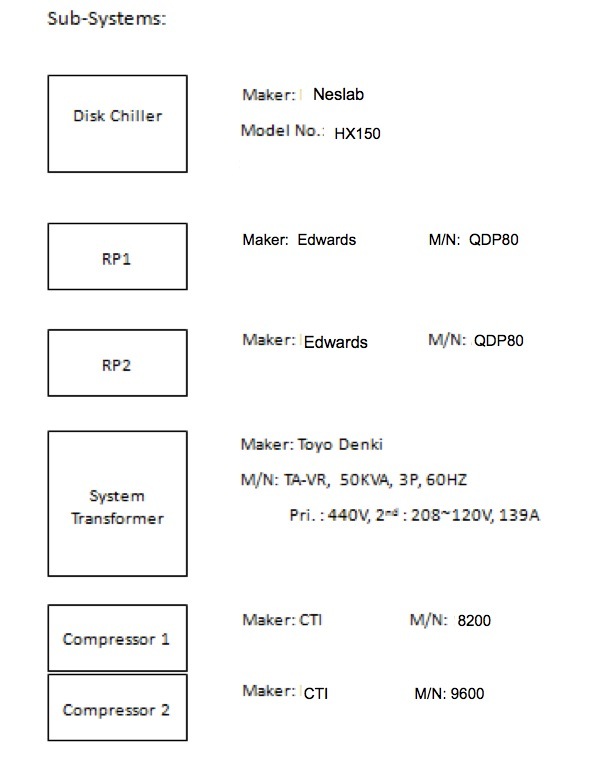

Vendu
ID: 9021872
Taille de la plaquette: 6"-8"
HC implanter, 6"-8"
180 KeV
Line power:
Input power: 208 V, 3 phase, 60 Hz, 92 A, 33 kVA, I/P breaker: 125 A
Output power: 180 KeV, 20 mA
Endstation module:
Mini-environment: Synetics
ATM robot: SEN
Notch / flat finder: flat
Dummy cassette: 2 in 1
Load buffer: 1
Vacuum cassette: domed pin
Cassette table: 4
Load port interface: manual
Beam profile oscilloscope: Tektronix TDS210
Cell controller / version: MVME 177-03
Load lock type: GSD 100/200, HE
Main SUN computer: Sparc Station 5
Second SUN computer: Spare 5
Second SUN monitor: Sun
Tape reader: n/a
Printer: HP
Process module:
Disk: none
Faraday flag: Y (no burn-through sensor)
Electron / plasma shower: secondary electron
Plasma shower PS: EMI EMS series
Bias aperture: Y
Shower gas panel: Y (Ar)
Ar / Xe bleed MFC: Unit 5 SCCM
In-vac arm: Y
Wafer holder: Y
Pedestal: Y
Gyro / angle: NF-GSD 100, Quad ± 11 deg
Linear drive: Y
Rotary drive: direct drive
HYT: no
Beamline module:
HV power supply: Advance HV
HV stack: OL8000/104/05, 100 kV
Prost accel. volt: OL800/104/05, 100 kV
Extraction suppression PS: Glassman, m/n: PS/NV-15NN33
AMU: BSL
AMU PS: EMI EMS 40-150
Hall probe: AMU
Max extraction voltage: 90 KeV, max acc. voltage: 90 KeV
Beam profiler hole: extended Y-scan
Decel. funcion: n/a
Beamline purge kit: Y
Beamline turbo: Y
Source module:
Source head: ELS without vaporizer
Filament PS: EMS 10-60
Arc PS: EMS 150-7
Cathode PS: Y
Vaporizer PS: present
Source magnet: std
Source magnet PS: EMS 25-25
Source bushing: std (orange)
Extraction assembly: LE-VAE, 33 type
Selectable resolving aperture: Y
Source ISO transformer: dry
Source injection kit: MKS 1150 vapor source MFC
Source housing exhaust valve: Y
Gas box module:
Gas box type: modular
Gas loop #1: Ar, HP (external supply)
Gas loop #2: BF3, SDS (fitting: 1/4" VCR)
Gas loop #3: AsH3, SDS (fitting: 1/2" VCR)
Gas loop #4: PH3, SDS (fitting: 1/2" VCR)
Loop #1 MFC: MKS, m/n 1179A-14493, 10 sccm, N2, gold finger conn.
Loop #2 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Loop #3 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Loop #4 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Vacuum system:
P1 / source turbo: Seiko Seiki, STP-A2203C
P8 turbo: Leybold 1000C
P3 / V3 cryo pump: CTI-10
P9 / disk cryo pump: n/a (flange ready)
RP2: Ebara A70W, 200-220 V, 3 phase, 50/60 Hz, 29.5 A
IG1: glass, G-75
PIG1: n/a
IG2: glass, G-75
IG3: glass, G-75
IG4: n/a
IG controller: GP-307
Safety options:
VESDA: n/a
Smoke detector: Y
CES options: n/a
Others:
Enclosures: OK
Ground bars: 5
SECS / GEM function: GEM
SPC function: yes
Dose controller PComp. algorithm type: standard PComp.
Crated
1998 vintage.
EATON NOVA/AXCELIS GSD 200E2 est un implant ionique et un moniteur. Il est conçu pour être utilisé dans les installations de fabrication de semi-conducteurs pour le processus d'implantation ionique. Ce procédé est utilisé pour modifier différents matériaux avec différents ions pour créer différentes propriétés ou caractéristiques dans le matériau, comme l'ajout d'atomes dopants impuretés au matériau silicium pour des propriétés électroniques spécialisées. AXCELIS GSD 200E-2 utilise des composants propriétaires tels que la technologie de mise en forme de faisceaux hybrides OptiCap et l'équipement de livraison de faisceaux ioniques IonControl SmartScan pour garantir le plus haut niveau de précision et de précision dans le processus d'implantation. Ceci est essentiel pour s'assurer que le matériau obtenu possède les propriétés et les caractéristiques souhaitées. EATON NOVA GSD 200 E2 utilise également une gamme de capteurs pour surveiller les contaminants particulaires dans la chambre d'implantation, ainsi que pour suivre les performances du système et les diagnostics. Ceci est important pour garantir que le processus d'implantation est optimisé pour les plus hauts niveaux de qualité dans le matériau résultant. L'unité GSD 200E2 EATON NOVA se compose de plusieurs composants, dont une source d'ions, une chambre d'implant, une machine de pompage à vide, une accélération RF, un outil haute tension, une console de contrôle ionique et un atout de contrôle paramétrique élevé. La source d'ions est responsable de la génération des ions pour le processus d'implantation, tandis que la chambre d'implant abrite ces ions et aide à les accélérer aux niveaux d'énergie appropriés. Le modèle de pompage à vide est chargé de créer l'environnement de vide approprié pour une implantation continue. L'équipement d'accélération RF augmente les ions à leurs états d'énergie requis pour l'implantation. Le système haute tension fournit l'énergie électrique nécessaire à ces processus. La console de contrôle ionique est ce qui permet aux opérateurs de contrôler le processus d'implantation et l'unité de contrôle des paramètres élevés permet de surveiller le processus d'implantation et les capteurs supplémentaires. En outre, EATON NOVA GSD 200E-2 dispose d'une chambre de neutralisation par plasma passif intégrée qui élimine la nécessité d'un dispositif distinct pour neutraliser la chambre d'implantation. Cette caractéristique permet de s'assurer que les niveaux de stabilité de la chambre sont plus élevés et qu'il y a moins de risques de contamination par le procédé. EATON NOVA/AXCELIS GSD 200E-2 est un implant et un moniteur d'ions avancés, et il est essentiel pour s'assurer que les niveaux de précision et de précision les plus élevés sont atteints dans le processus d'implantation, et que le matériau résultant a les propriétés souhaitées. C'est pourquoi il est utilisé dans de nombreuses installations de fabrication de semi-conducteurs à travers le monde.
Il n'y a pas encore de critiques