Occasion FEI FIB 200 #9082663 à vendre en France
Il semble que cet article a déjà été vendu. Consultez les produits similaires ci-dessous ou contactez-nous et notre équipe expérimentée le trouvera pour vous.
Appuyez sur pour zoomer
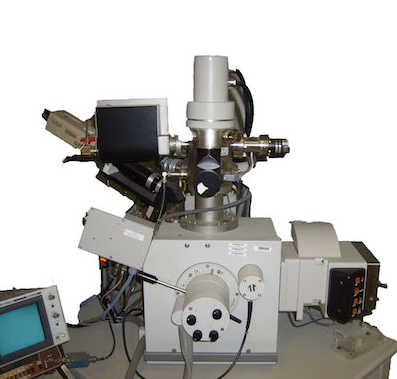

Vendu
ID: 9082663
Focused Ion Beam System
Single beam
Pre-lens ion column:
Provides image resolution of 7nm and milling current up to 11nA
Enables deflection (for scanning) before the final lens, bringing the lens closer to the sample for best spot size
50x50mm XY stage, with rotation, tilt and z-motions
Loadlock with separate pump for fast sample exchange
Turbo pump for main chamber
Real time monitor to observe milling, aka Leader oscilloscope
Keithley Pico-ammeter to measure beam current
(2) GIS types to be selected from: EE, IEE, Metal dep (Pt) or TEOS
Chamber camera and monitor
Operating system: Windows NT
Computer control with FEI software and Seiko screen printer
Manual user interface (MUI), joystick and mouse controls
Manuals
(2) gas injectors with controller: choose from iodine, XeF2, Platinum, or TEOS gases
Line transformer (main), AC distribution box and Maintenance tool kit.
FEI FIB 200 est un microscope électronique à balayage avancé à haute résolution (SEM) conçu pour des applications telles que l'analyse des matériaux et la caractérisation des matériaux. Il utilise un faisceau ionique focalisé (FIB) pour permettre des images très amplifiées et détaillées de la structure interne des matériaux, ainsi que la capacité de prélever des échantillons avec une précision atomique. Grâce à son système électronique et optique de pointe, le FIB 200 offre une résolution plus élevée et un balayage plus rapide que la plupart des SEM. FEI FIB 200 utilise une source d'émission de champ pour fournir des électrons à des courants extrêmement élevés. Ces électrons sont focalisés par une série de lentilles électromagnétiques puis accélérés par une anode vers l'échantillon. Lorsque les électrons interagissent avec le matériau de l'échantillon, ils génèrent des signaux distincts qui sont ensuite détectés par le système SEM et traités en images. FIB 200 dispose d'un correcteur d'aberration sphérique qui lui permet d'obtenir des images de petite résolution. Le faisceau d'ions focalisés incorporé dans ce système est un aspect critique de la préparation des échantillons. La FIB permet aux utilisateurs de prélever une surface d'échantillon et de la découper en couches minces pour une analyse plus approfondie. Ce procédé de coupe est incroyablement précis, ce qui permet de préparer des échantillons avec une précision atomique. Il permet également l'élimination des atomes de surface et le dépôt de sondes et de substrats dans l'échantillon. FEI FIB 200 fournit également une suite d'outils d'analyse et de mesure d'images qui permettent aux utilisateurs d'analyser les matériaux avec plus de précision. Cela inclut des outils tels que la cartographie couleur multidimensionnelle et des modèles de fonctionnalités automatiques. Les données peuvent être exportées pour une analyse plus approfondie, ou sauvegardées pour une référence future. Dans l'ensemble, FIB 200 est un SEM avancé, équipé d'outils pour fournir des informations précieuses sur les matériaux nanométriques. Sa précision et sa résolution inégalées, associées à sa FIB intégrée, en font un instrument idéal pour l'analyse et la caractérisation des matériaux.
Il n'y a pas encore de critiques