Occasion JEOL JEM 2010F #293585832 à vendre en France
URL copiée avec succès !
Appuyez sur pour zoomer
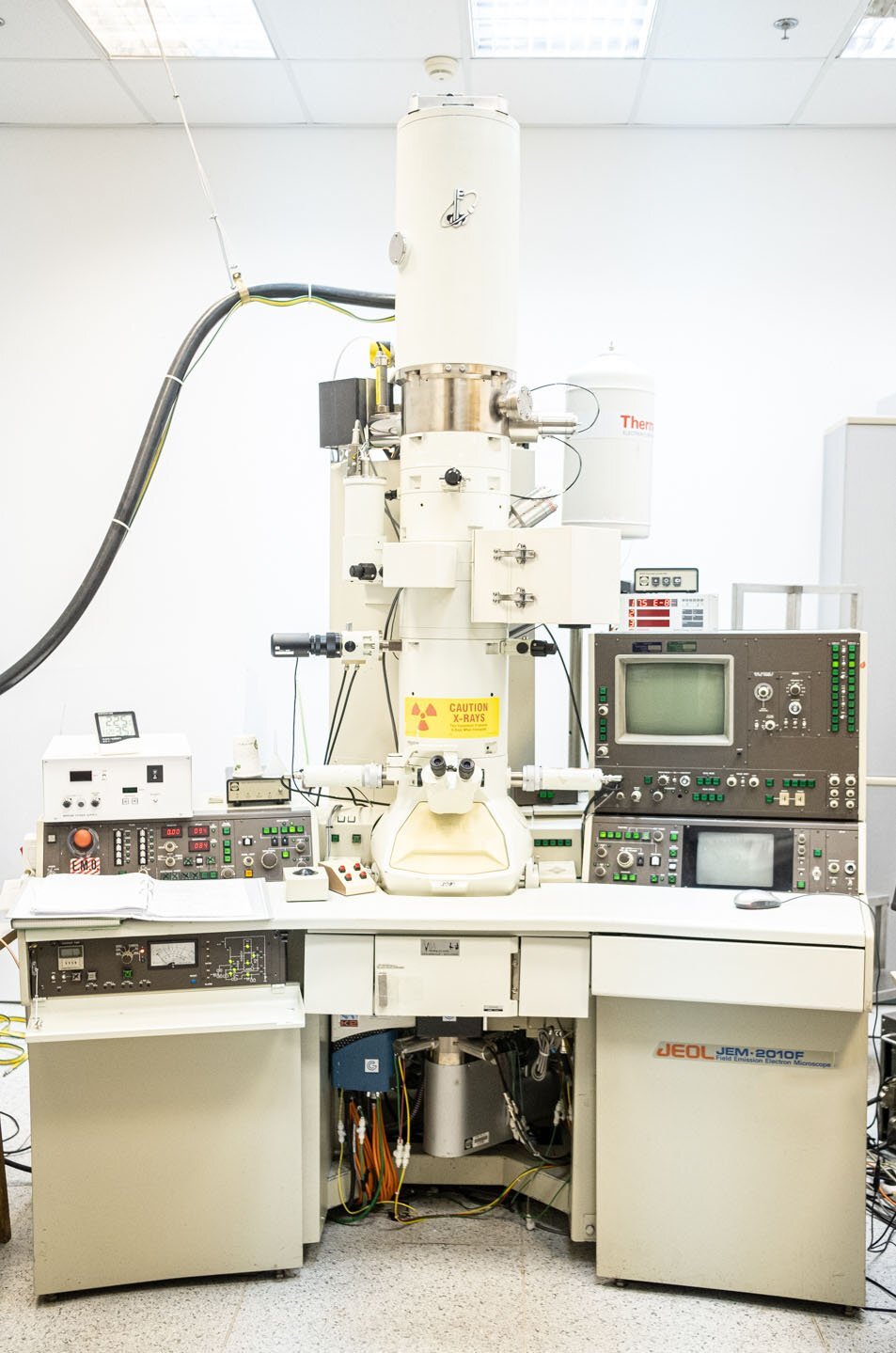





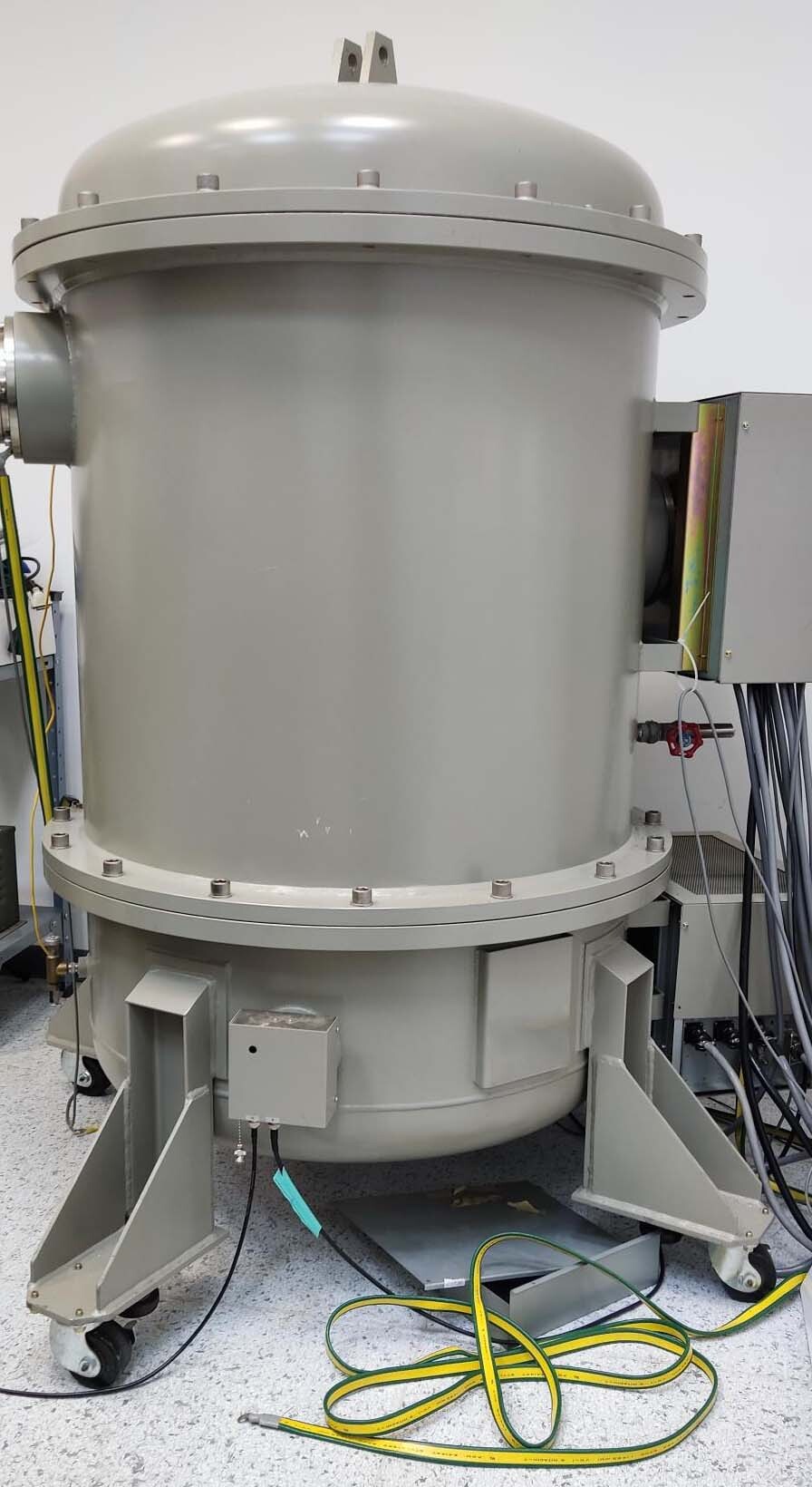









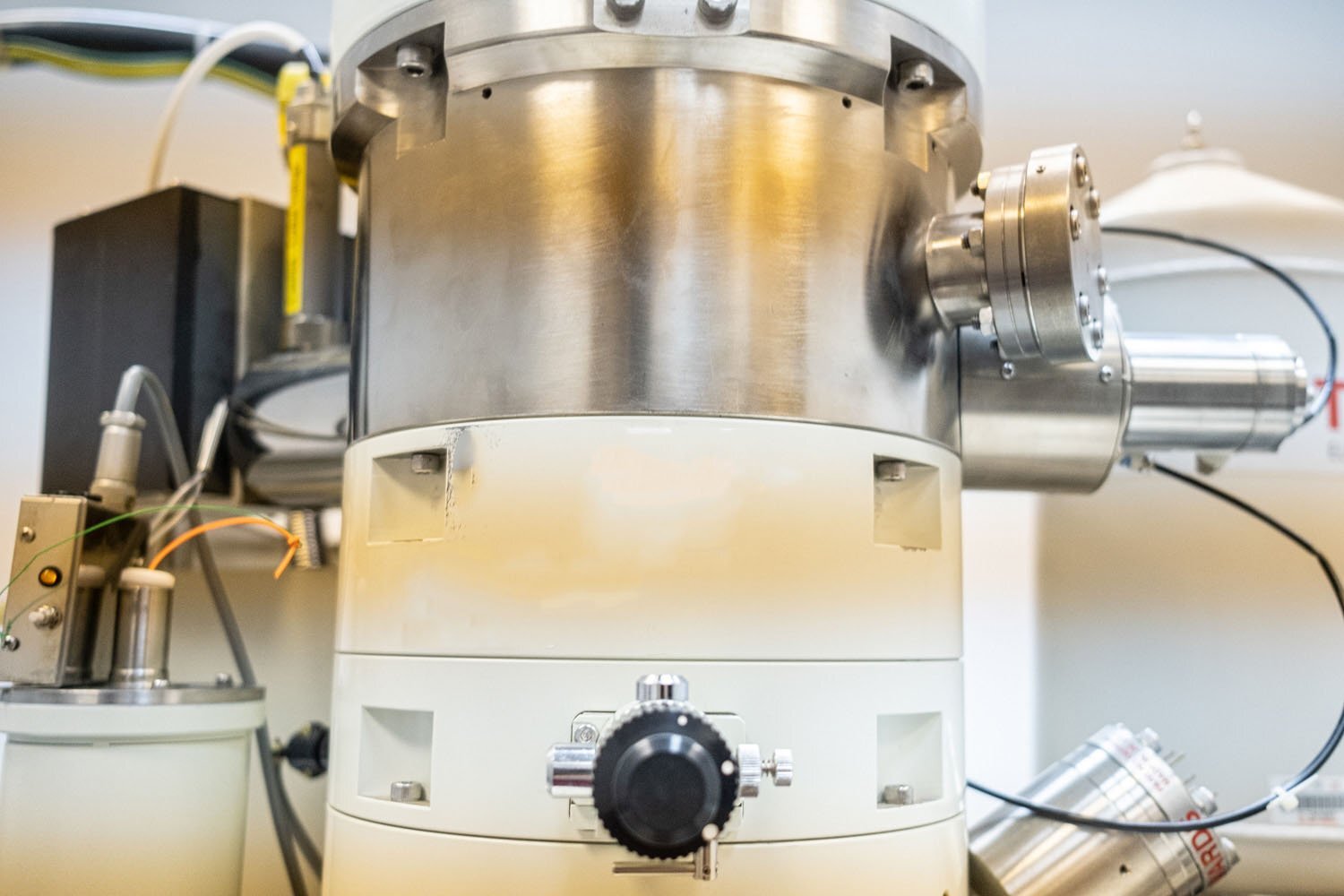































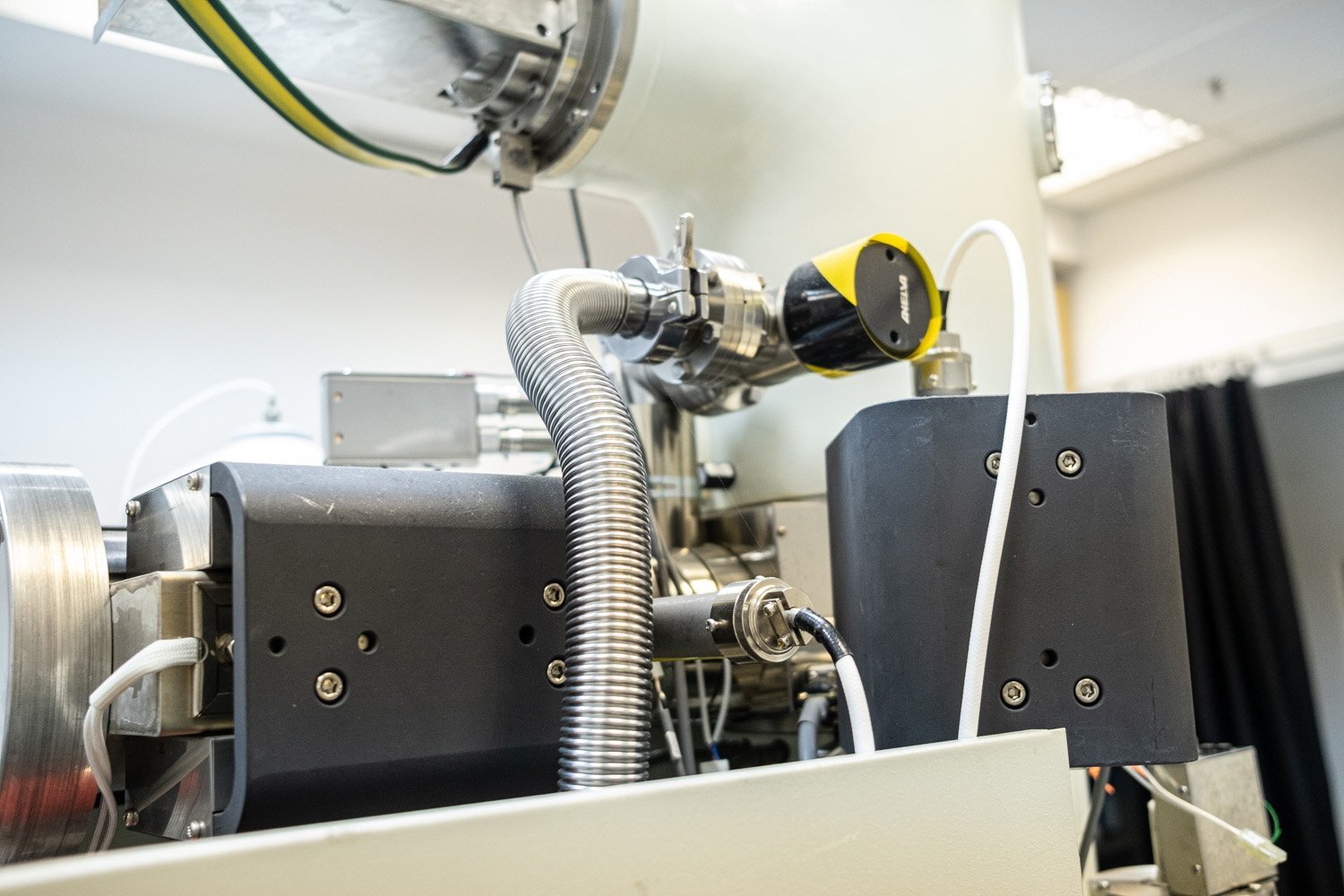





















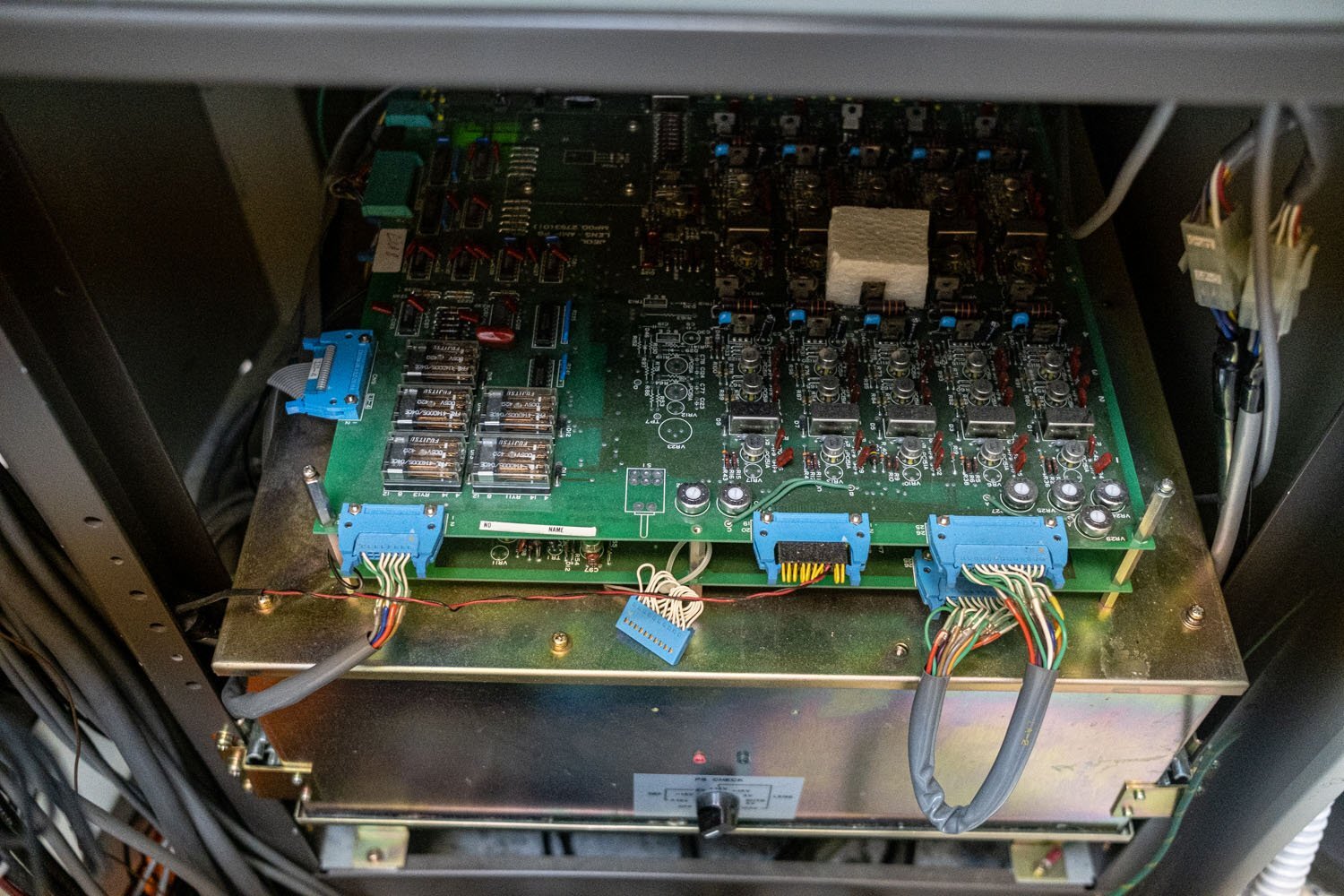

















































ID: 293585832
Scanning Transmission Electron Microscope (STEM)
UHR Objective pole
Spherical aberration coefficient: 0.5 mm
Point-point resolution: 0.19 nm
Information limit: 0.1 nm
Energy resolution: 133 eV
SiLi detector
Resolution imaging
Collection angle: 0.13 Sterad
Take off angle: 20°
Phase resolution: 100 rad
JEOL Bi-Prism electron holographic measurements
Medium and low magnifications
EDS
EELS
K2
Power supply: 80 kV-200 kV.
JEOL JEM 2010F est un microscope électronique à balayage avancé (SEM) qui fournit aux chercheurs, aux techniciens et aux experts de l'industrie les outils nécessaires à l'analyse sous-micron, niveau de fonctionnalités. JEOL JEM-2010F est optimisé pour une variété d'analyses de matériaux, d'observation de niveau micron, d'analyse de défauts et de fonctionnement automatisé. JEM 2010F offre une imagerie très haute résolution de petits échantillons, y compris des matériaux sous forme sèche et liquide. Il est capable d'analyser une gamme de tailles d'échantillons, de celle des ouvertures de 1 micron jusqu'à la gamme de 200 microns. Une grande profondeur de champ fournie par JEM-2010F permet la capture d'images détaillées à des grossissements élevés allant jusqu'à 150,000X. La combinaison de haute résolution et de profondeur de champ permet la détection de caractéristiques de contraste élevé de surface et de sous-surface telles que les inclusions, la corrosion, les limites des grains et les défauts cristallins. JEOL JEM 2010F fournit également une gamme de fonctions de microscopie automatisée rendues possibles par la technologie logicielle avancée. Les fonctions automatisées de JEOL JEM-2010F offrent à l'utilisateur de nombreuses options utiles, y compris la combinaison d'acquisitions d'images à plusieurs étapes de l'analyse, le travail sur plusieurs échantillons en même temps, et l'utilisation de divers outils pour contrôler le processus de numérisation. Le MJE 2010F comprend également un certain nombre d'options avancées d'analyse de signaux pour une gamme d'échantillons et de types d'analyse. Les outils d'analyse de signaux disponibles en JEM-2010F peuvent être utilisés pour analyser les modèles de signaux, les changements chromatiques et les cartes de chaleur afin de détecter les changements dans la microstructure des matériaux à des échelles extrêmement petites. La performance de JEOL JEM 2010F est encore améliorée par son équipement de contrôle intelligent (ICS). L'ICS intègre l'intelligence artificielle pour s'assurer que le système fonctionne correctement à chaque fois qu'il est exploité et que l'imagerie est optimisée. L'unité intelligente permet également des scénarios de mesure entièrement automatisés, offrant à l'utilisateur une imagerie plus rapide, un débit plus élevé et des résultats plus cohérents. En conclusion, JEOL JEM-2010F est un SEM avancé avec une gamme de fonctionnalités qui permettent l'imagerie en temps réel avec de grands niveaux de détail. Les fonctions d'imagerie automatisée et d'analyse de signal fournissent une gamme d'outils puissants pour garantir des résultats de haute qualité tandis que la machine Intelligent Control fournit fiabilité et précision dans chaque image.
Il n'y a pas encore de critiques