Occasion PHILIPS / FEI XL 30 #293619811 à vendre en France
URL copiée avec succès !
Appuyez sur pour zoomer
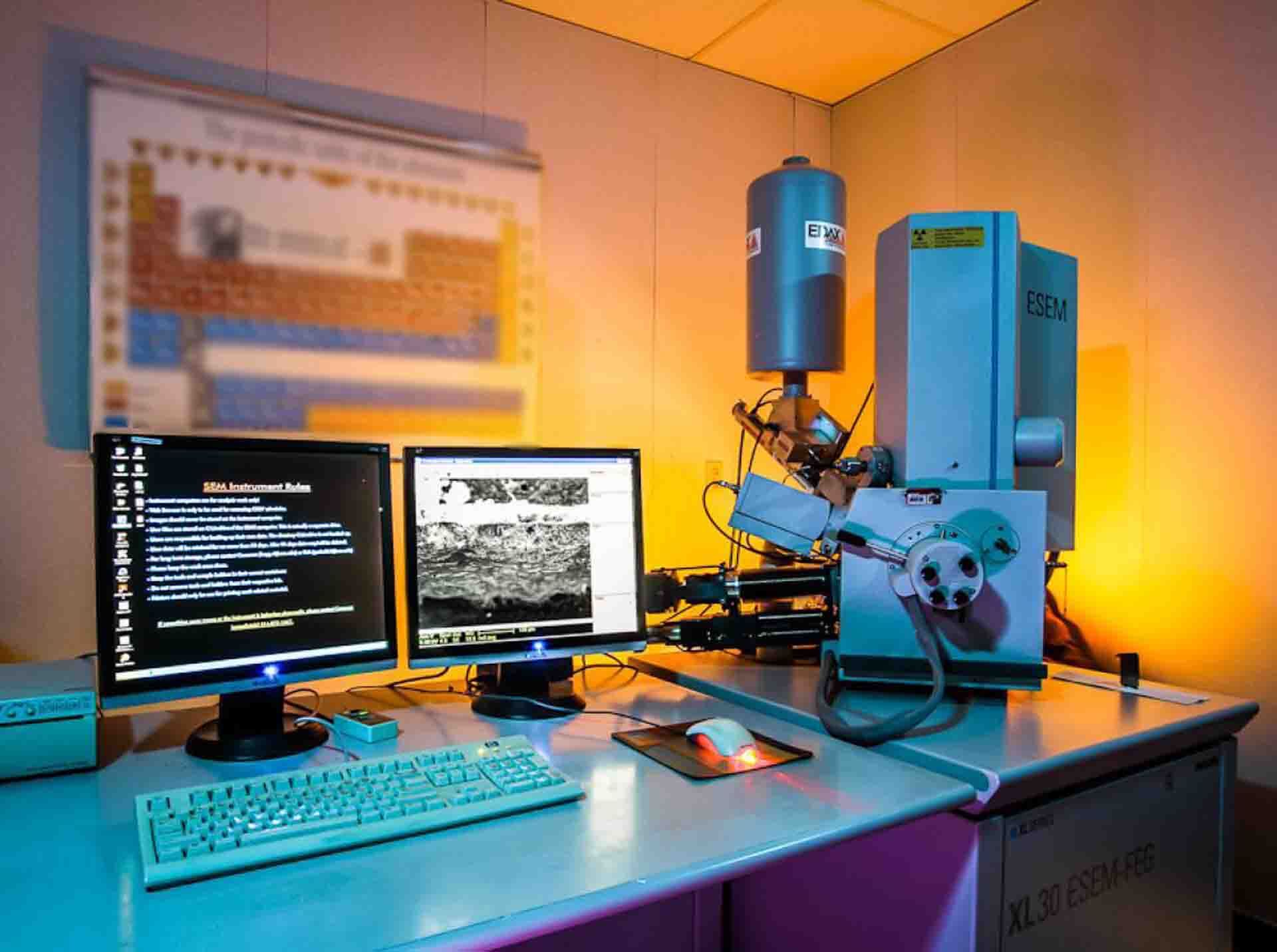

PHILIPS/FEI XL 30 est un microscope électronique à balayage (SEM) conçu pour l'imagerie et les analyses au niveau submicronique. Il est doté d'un système de spectrométrie à rayons X dispersive d'énergie (EDS) et d'un canon à émission de champ avec correction de l'aberration. Le FEI XL 30 propose trois modes d'imagerie : l'imagerie par électrons secondaires et rétrodiffusés (ESB) ou un mode d'imagerie basse tension qui utilise des kV plus faibles pour améliorer les performances à des grossissements élevés. PHILIPS XL30 peut atteindre des grossissements jusqu'à 500.000x avec une résolution de 0,750nm, une fenêtre de pression de 0.35-420PA, et une taille de chambre de .5 x .6mm. Le système de détection est constitué d'un détecteur bimodal, d'un détecteur secondaire d'électrons et d'un détecteur à rayons X dispersifs d'énergie (EDX). Le détecteur bimodal comprend un détecteur non réfléchissant courbe, un détecteur d'impulsions de synchronisation et un détecteur de taches à flux ouvert. Le détecteur d'électrons secondaire mesure les électrons émis et est équipé d'une fente annulaire qui permet une résolution de trajet plus fine. Le détecteur EDX permet l'analyse élémentaire et est équipé d'une grille antiscatter et d'une fenêtre de rayons X en aluminium. FEI XL30 peut analyser des échantillons à vide faible ou élevé. Une chambre d'échantillonnage est utilisée pour introduire l'échantillon et les conditions environnementales sont contrôlées afin de réduire l'influence de l'humidité et des contaminants sur l'échantillon. Un étage de chauffage peut être utilisé pour chauffer l'échantillon jusqu'à un maximum de 3000 ° C L'interface utilisateur de PHILIPS/FEI XL30 peut être programmée pour contrôler tous les paramètres du microscope et stocker les valeurs par défaut pour tous les paramètres. L'utilisateur peut stocker et récupérer des profils complets pour chaque mode d'imagerie. L'utilisateur dispose également de plusieurs options pour contrôler l'angle de vision, l'agrandissement et la forme du faisceau. XL30 offre une gamme de possibilités d'analyse, y compris la micrographie électronique, la caractérisation, la topographie de surface, l'analyse élémentaire et la spectroscopie, l'analyse des défaillances et le bétonnage. Sa performance est encore améliorée par la correction d'aberration (CAC) et la technologie de réduction de kV. La grande stabilité et le faible niveau de bruit du système permettent aux utilisateurs d'effectuer des mesures précises, tandis que sa précision et sa cohérence donnent une reproductibilité des résultats.
Il n'y a pas encore de critiques