Occasion VON ARDENNE WM70H / C #9172921 à vendre en France
URL copiée avec succès !
Appuyez sur pour zoomer




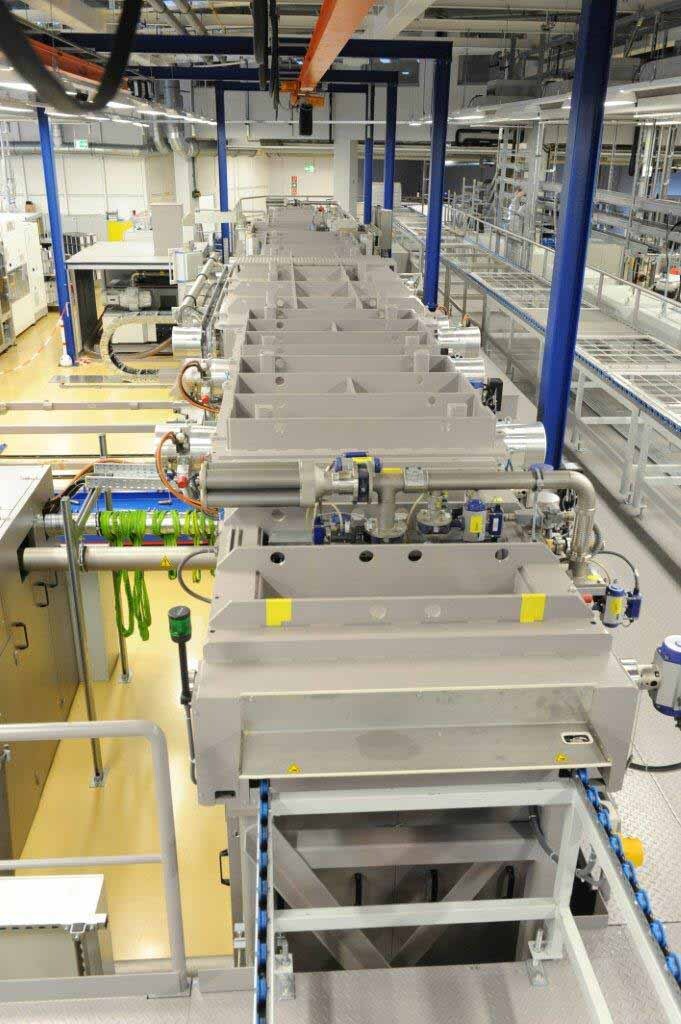



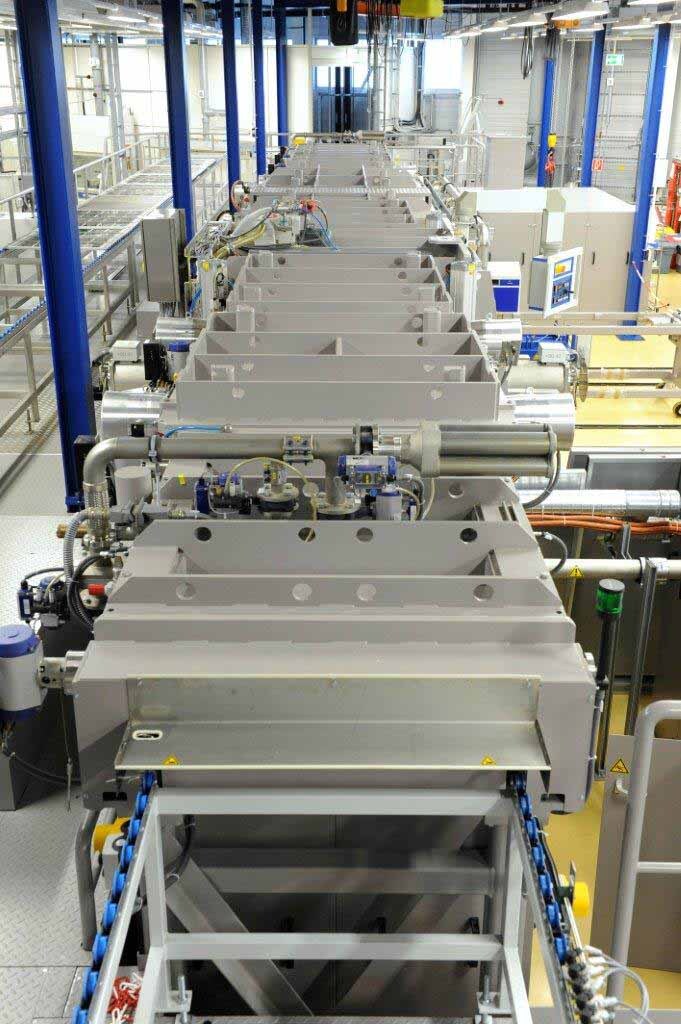



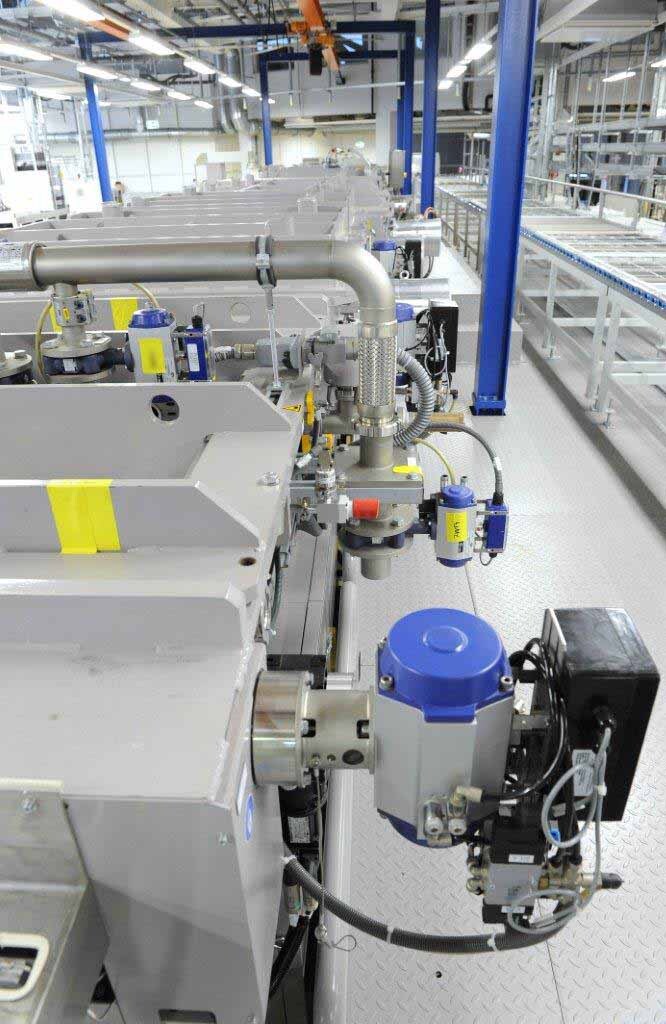

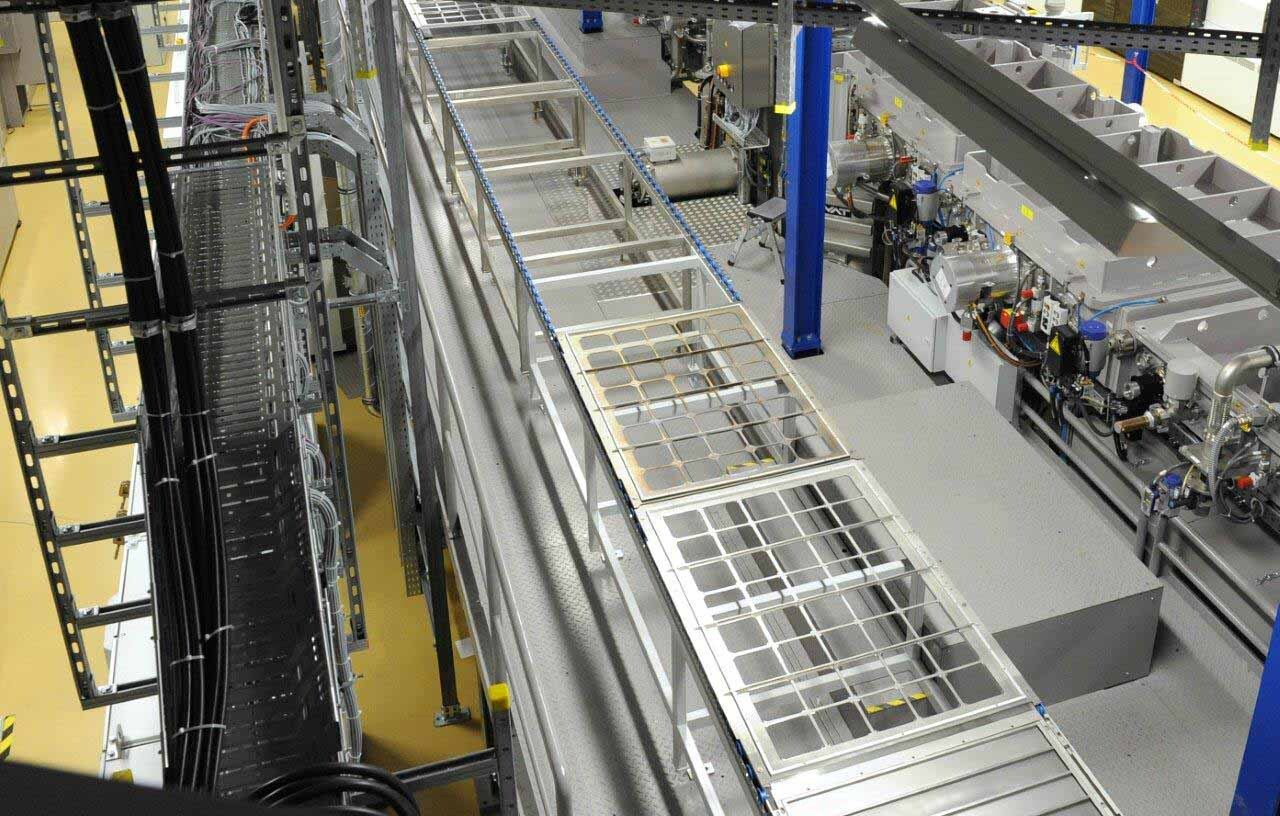



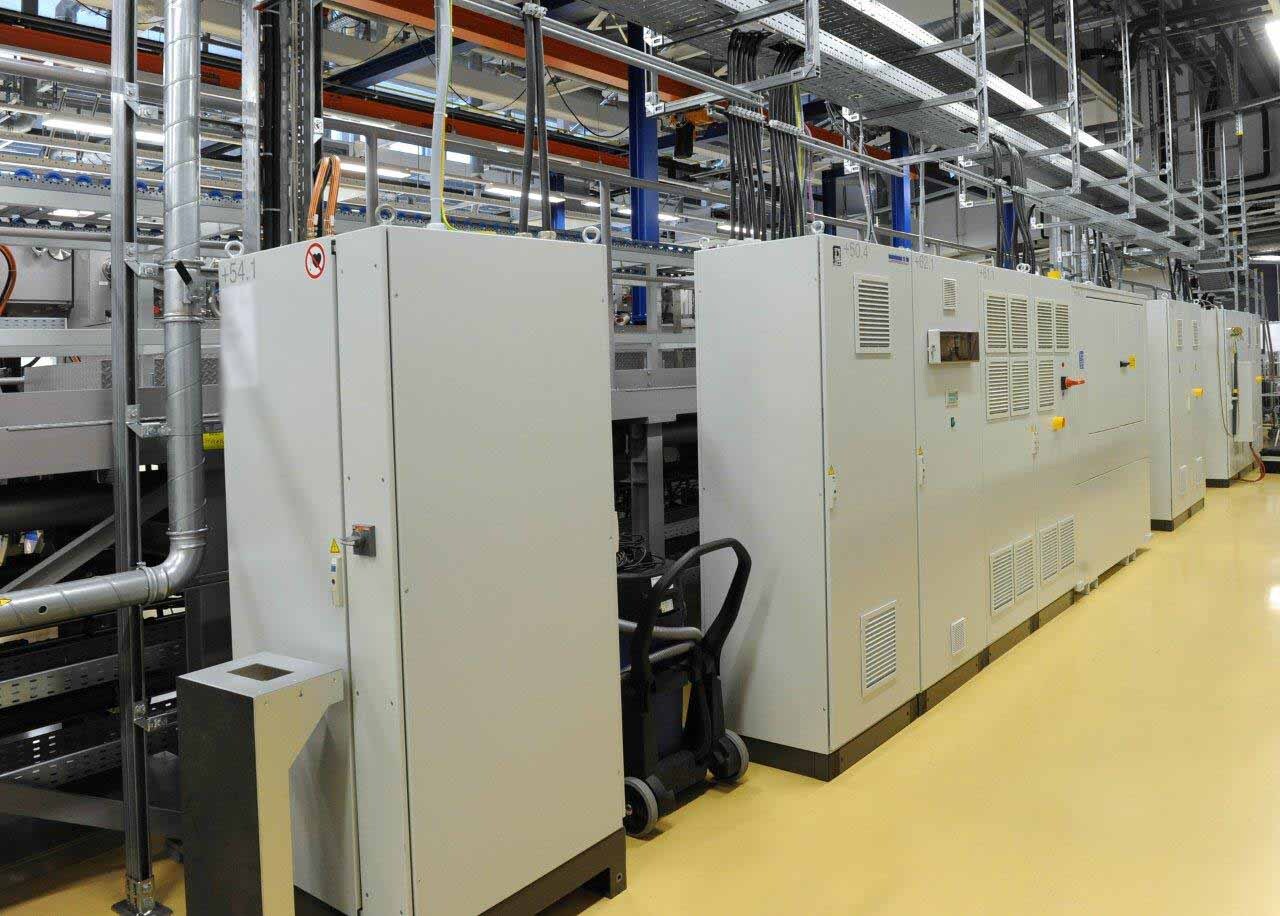







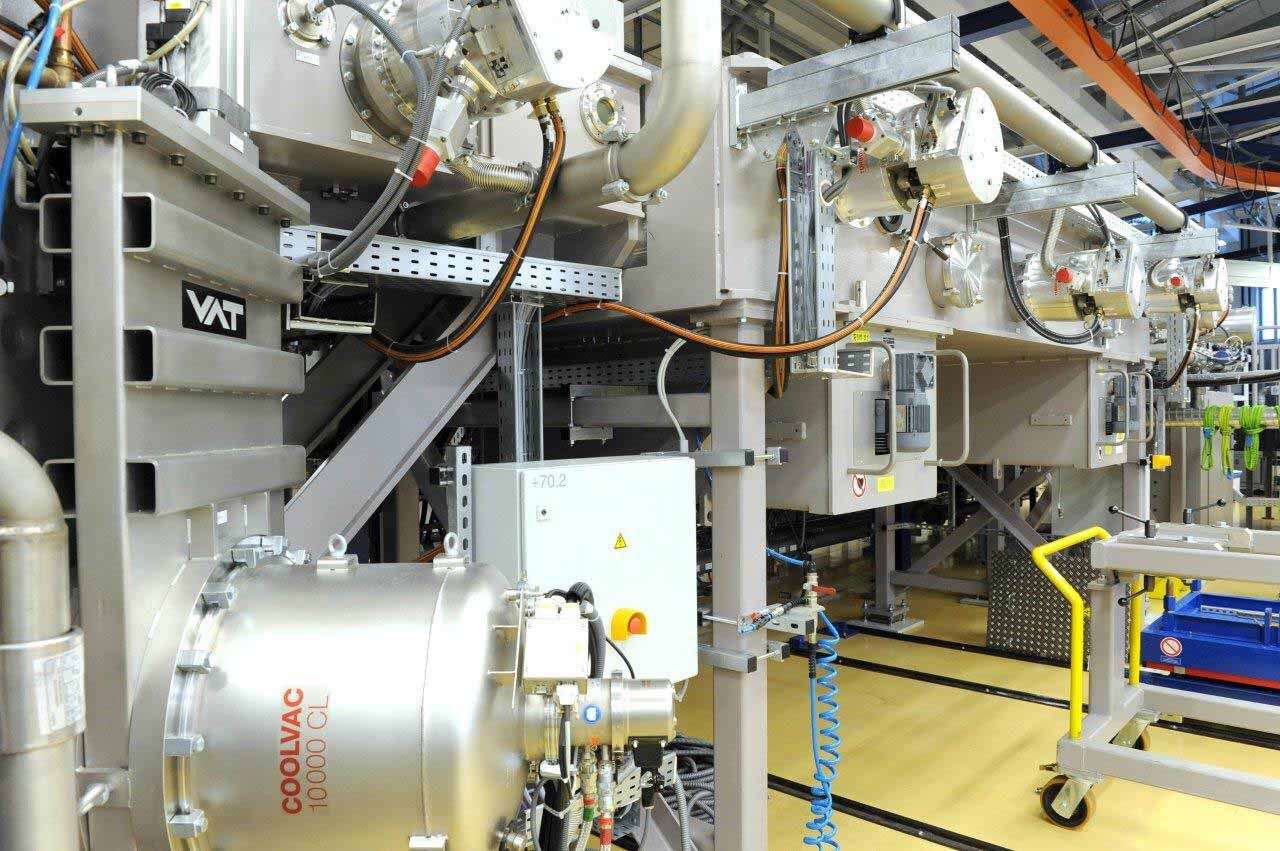





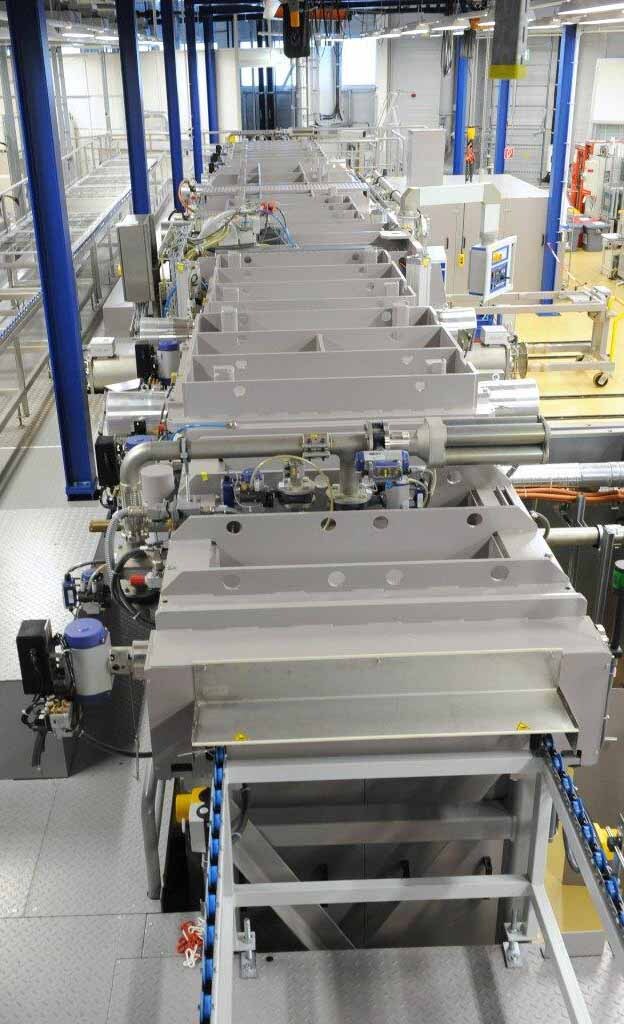













ID: 9172921
High end coating line
Wafer metallizer
In-line complete system for coating wafers
Back coating of silicon wafers with an aluminum layer
Coating of nickel, silver and aluminum by electron beam evaporation
(35) Cells can be coated per tray
Productivity:
4,000 Wafers (5") per hour
2,600 Wafers (6") per hour
Cycle time: 50s
Technical parameters:
System dimensions:
Length: 19 m
Area: 20 x 7 m
Height: ~3 m
Drive:
Carrier speed max: 5 m/min
Carrier speed during vapor deposition: 1.5 - 2.0 m/min
Substrate temperature:
Max. temperature: 300°C / 572°F
Carrier dimensions:
Length: ~1,450 mm
Width: 925 mm
(60) Wafers (5") per carrier
(40) Wafers (6") per carrier
Ambient conditions:
Ambient temperature:
+15 to 35 °C
+59 to 95 °F
Relative humidity at 30°C / 86°F: < 70 %
Dust: < 10 mg/m3
Sluice chambers C1 and C7
Buffer chambers C2 and C6
Transfer chamber C5
Process chamber C4:
EB Chamber C3 / C4.1 / C4.2
Sputter chambers
(5) Sections (C4.3 to C4.7)
Vacuum
Working pressure:
C2 - Buffer chamber 2 to 5 x 10-3 mbar
C4.1 - EB chamber 5 to 9 x 10-5 mbar
C4.2 - Intermediate chamber 2 to 5 x 10-4 mbar
C4.3 - Intermediate chamber 2 to 5 x 10-3 mbar
C4.4 - Sputter chamber 2 to 5 x 10-3 mbar
C4.5 - Pump chamber 2 to 5 x 10-3 mbar
C4.6 - Sputter chamber 2 to 5 x 10-3 mbar
C4.7 - Intermediate chamber 2 to 5 x 10-3 mbar
C5 - Transfer chamber 2 to 5 x 10-3 mbar
C6 - Buffer chamber 2 to 5 x 10-3 mbar
Leak rate: < 1 x 10-2 mbar l/s-1
Layer thickness / Properties:
AI with copper:
Thickness: 2 μm
Wafer thickness: > 200 μm
Temperature: 400°C / 752°F
Purity: 99.98%
AI with ceramic:
Thickness: 3 μm
Wafer thickness: 150 to 250 μm
Temperature: 300°C / 572°F
Purity: 99.5%
Ag: Thickness: < 300 nm
Sn: Thickness: < 300 nm
NiCr: Thickness: < 40 nm
Uniformity: ± 10%
Evaporation:
Production cycle: 120 h
Power of electron beam
Copper crucible: 100 to 200 kW
Ceramic crucible: 20 kW
Target material per cycle: 90 to 150 kg
Vapor utilization: 48 to 50 %
Target-substrate distance: 600 mm
Carrier frequency: 60s
Sputtering:
Target material: Ag
Target utilization: ~70%
Target life: 240 h
Cooling water:
Particle size: ~50 mg/l
pH Value: (8.0 to 9.0)
Electrical conductivity: (150 to 250) μS/cm
Acid capacity, Ks 4.3: (0.5 to 2.0) mmol/l
Filterable substances: < 50 mg/l
Chloride: < 10 mg/l
Sulfate: < 30 mg/l
Ammonium: < 0.5 mg/l
Nitrate: < 10 mg/l
Colony count (CFU): ~ 1,000 ml-1
TOC (total organic carbon): < 1.5 mg/l
Inlet temperature:
21 to 25°C
69.8 to 77°F
Differential pressure: 2 bar
Absolute pressure max: 8 bar
Water circuit 1 chambers:
Volume flow: TBD m3/h
Temperature: 25°C / 77°F
Required pressure: 6 - 8 bar
Cooling capacity: TBD kW
Electrical system:
3 Phases, 3 AC 480 V
Tolerance: -10/+6 %
Frequency: 59 to 61 Hz
Grounding resistance: <2 Ohm
Connected load max: 400 kVA
Function:
Wafers are coated on one side with (2) metal layers.
VON ARDENNE WM70H/C est un équipement photorésist de pointe capable de produire des images et des motifs en couches minces de haute qualité. Le système est conçu pour créer des tailles jusqu'à 70 nm de largeur et 100 nm de hauteur avec une précision de 2 nm. L'unité comprend plusieurs composants tels que des photomasques, une machine de lithographie, de nombreux composants fluidiques, un distributeur de gaz et une source de résine. Les photomasques, qui servent à modeler la surface de la plaquette, sont d'abord chargés dans la machine de lithographie. Ensuite, les composants fluidiques distribuent rapidement la résine (un mélange chimique) sur le photomasque et la plaquette et contribuent à sa diffusion uniforme. La résine est ensuite exposée à la lumière d'une source d'inondation pour créer un motif de résistance qui fonctionne comme un modèle dans lequel les détails de surface seront formés. Un distributeur de gaz applique précisément un film de protection fluorocarboné sur la surface de la résine pour manipuler le flux gazeux et assurer la cohérence de l'émulsion. La résine est ensuite dénudée, rincée et séchée, et la plaquette est alors prête à subir une nouvelle gravure et à être dénudée. TheWM70H/C machine présente les composants les plus modernes du marché et offre une précision de placement d'image supérieure, une définition de motif de précision et une structure de film haute fidélité pour les processus de lithographie à semi-conducteurs entre 70 et 100 nm. Lorsqu'il est utilisé en combinaison avec un outil d'imagerie harmonique après gravure, WM70H/C offre des caractéristiques claires et détaillées, avec une précision de 2 nm. En outre, son large éventail de paramètres et d'opérations automatisées garantit un temps de mise en place minimal, ce qui se traduit par des gains de productivité importants. Il est idéal pour les environnements de production à haut volume de procédés semi-conducteurs avancés.
Il n'y a pas encore de critiques